半導体試験装置(テスタ)

半導体テスタ
ウェーハ検査工程やパッケージ後の最終工程でデバイスの良否判定をおこなう装置です。
当社では、半導体ICの開発/不良解析から量産まで、ニーズに適したテストソリューションをハード・ソフト両面からご提案します。
テスト環境や予算に応じ、ご要望に合わせて機能を絞り込んだコストパフォーマンスの高い専用テスタ/テストシステム開発を承ります
-
01要望に応じた新たなテスト・モジュールの提供が可能で、幅広いデバイスのテストに対応
-
02テストパターンの容量制限がなく、大規模なデバイスのテストも可能
-
03テスト・モジュール構成に応じ筐体サイズを3タイプより選択可能
-
04筐体内に電源・制御PCを内蔵し省スペース
お客さまのデバイスとテスト環境に応じ、3種類の共通プラットフォーム化された筐体をラインナップしました。


半導体試験装置(テスタ)とは
半導体テスタとは、半導体デバイスに電気信号などを与え、出力される信号を期待値と比較することで、設計仕様通りに動作するかどうかを検査する装置です。ATE(Automated Test Equipment)ともよばれています。
テスタはロジックテスタ、メモリテスタ、アナログテスタに大きく分類されます。通常半導体の検査は、ウェーハ状態で検査するウェーハ検査(ダイ・ソートやプローブ検査などとも呼ばれる)と、パッケージ後に行なわれるパッケージ検査(ファイナル検査などとも呼ばれる)の2段階で行なわれます。ウェーハ検査ではプローバとプローブカードが、パッケージ検査ではハンドラーとテストソケットが、それぞれテスタと共に用いられます。
【テスタ】

【ウェーハ検査装置】
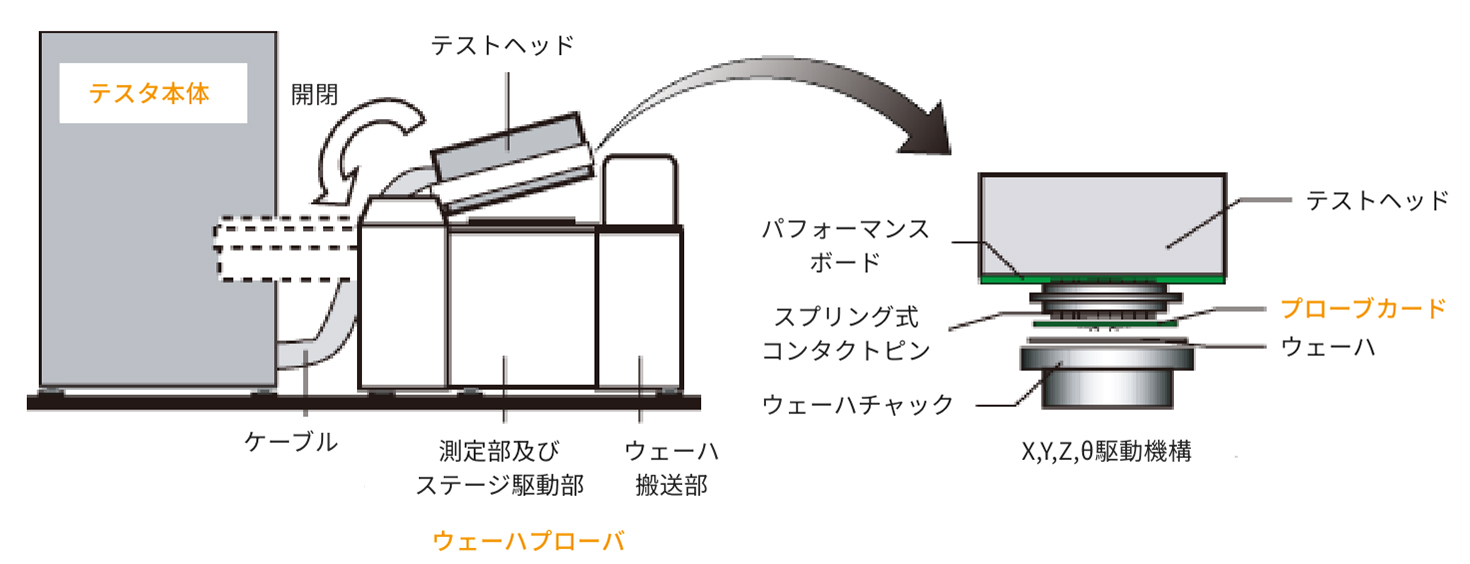
DFTとは
DFT (Design For Testability) はテスト容易化設計のことです。
IC 設計の初期段階から、テストのし易さを考慮した回路の構造にしたり、テスト用回路の組込みなどを行います。正確なテストを短時間に行え、テストコストの低減が期待できます。BIST や Scan テストが DFT の代表的な例として挙げられます。

BISTとは
BIST(Built-in Self Test)はDFT技術の1つです。
本来テスタが持つ機能の一部を、ICの回路の内部に組み込んで、IC自身が自己テストを行う手法です。IC内のBIST回路にはテスト対象回路に加えるテスト・パターン生成、テスト対象からの出力パターン圧縮、圧縮されたパターンと期待値との比較、などの機能が含まれます。テスタに要求される機能が限定される、同時に多数のICの検査が行えるなど、テストコストの低減も期待できます。メモリ回路検査用のメモリBIST、ロジック回路検査用のロジックBISTなどがあります。
SCANテストとは
ScanテストもDFT技術の1つで、ロジック回路をテストする手法の1つです。
構造検査のひとつで、IC内部の回路のオープンやショートなどにより論理値が常に1もしくは0になるモードの故障を検出します。
Scanテスト時にIC内部にテスト用のScanチェーンと呼ばれるFF(フリップフロップ)のチェーンを構成します。テスタからのテストパタンデータをFFのチェーン経由でテスト対象回路ブロックに送り、テスト対象の内部状態を反映した応答をFFのチェーン経由で取り出します。予め想定した応答パターンと比較する事で内部の故障個所が検出できます。
故障モデルを予め想定し、回路設計データから不良を特定しやすくするパターンをソフトウェアによって自動で生成する事で、大規模なICでも短時間で故障検出率の高いテストが行えます。